行业研究数据库
行业图谱研究
行业深度新闻

创业投资数据库
知名创投机构
重点项目动态

证券研究数据库
中国宏观数据
区域上市企业

2022-09-03
先进制造 | 行业数据
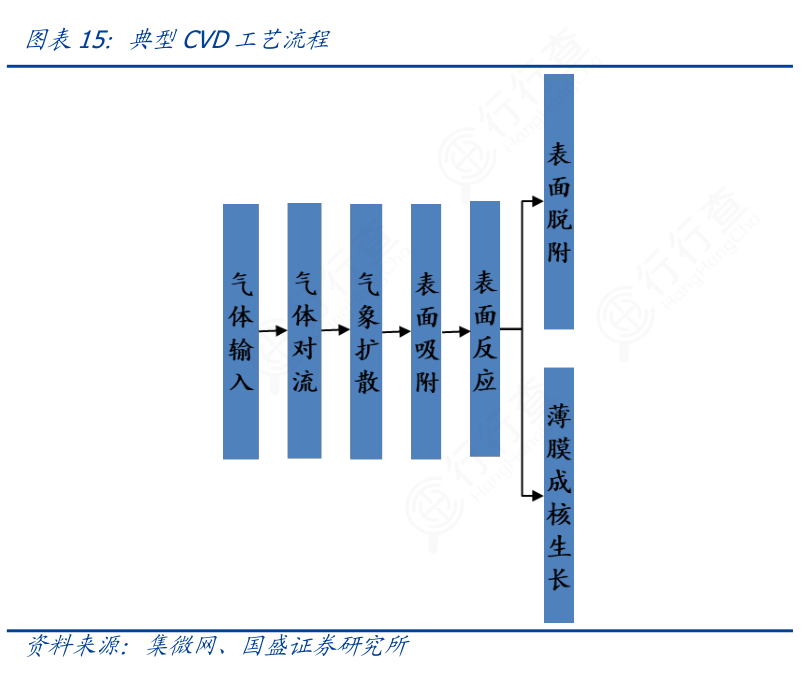
4)45nm以后,高介电材料(Highk)和金属栅(MetalGate),引入原子层沉积(ALD)设备,膜层达到纳米级别。——(a)高介电材料(Highk)替代SiO2,用于制备MOS器件的栅介质层,需要引入ALD。(b)多晶硅同步地被替代为金属栅(MatalGate)电极,也用ALD设备制备。
半导体新材料
登录网站查看更多数据




 行研数据库
行研数据库  图表数据
图表数据 
 研究报告
研究报告 
 产业数据
产业数据  创投数据库
创投数据库  创业投资
创业投资  基金备案
基金备案  城市经济
城市经济  证券数据库
证券数据库  招股书
招股书  证券研究
证券研究  上市发行
上市发行  商业数据库
商业数据库  专业数据
专业数据 








