


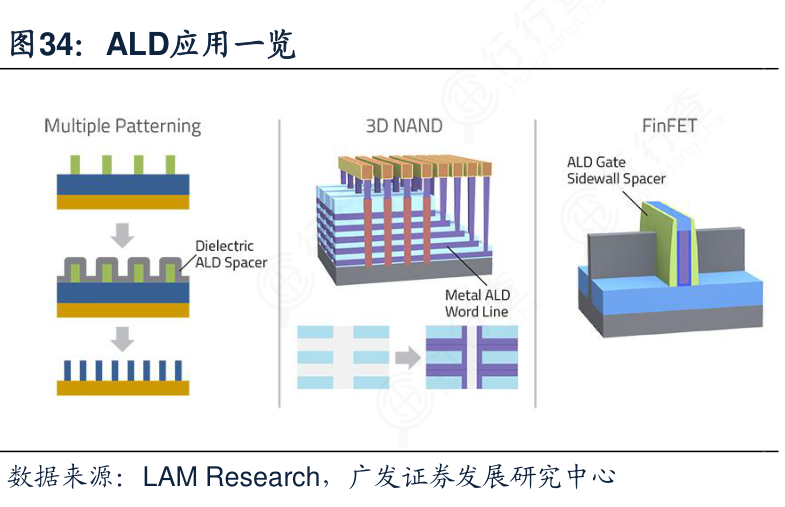
以外的沉积较少,停工清洗时间更短。主要用于制备二氧化硅、氮化硅、氮氧化硅薄膜等。与LPCVD相比,PECVD的热预算更低,膜应力也有明显改善。HDPCVD的优点在于低热预算(300-400℃)下高深宽比间隙的填充,被用在制作ILD,ILD-1,STI,刻蚀终止层以及低K介质的淀积。应用等离子体的CVD技术已成为CVD乃至薄膜沉积的主流。据Gartner统计2020年全球等离子体CVD设备市场空间达47亿美元,远超其他类别的沉积设备。应用材料、泛林半导体的此类设备市占率分别为49%和34%,设备种类更全,在薄膜材料和淀积指标上处在领先地位。著,电子工业出版社出版),广发证券发展研究中心炳卿等),广发证券发展研究中心原子层沉积(ALD):原子层沉积以基本的CVD方法为基础,使用脉冲调制技术,用清除气体将每种反应剂分离,在先进晶体管、存储器件和互连应用中制造各类氧化物、金属氮化物和金属物超薄薄膜层,每次沉积单层厚度的几分之一。其特点为原子层的自限性和共形沉积。根据反应控制方法不同,ALD分为空间交替方法和时间交替方法,前者通过移动晶圆使其暴露于不同的前驱体,后者保持晶圆不动而交替地将前体引入/移除到腔室。ALD最大优点是薄膜厚度均匀性,在高深宽比(>100:1)空隙和3D结构的顶部、侧面和底部可以获得相同的膜厚度,缺点是沉积速度慢,约1A/min。ALD应用包括高k栅介质、扩散阻挡层和存储器结构的电极薄膜层等。




 行研数据库
行研数据库  图表数据
图表数据 
 研究报告
研究报告 
 产业数据
产业数据  创投数据库
创投数据库  创业投资
创业投资  基金备案
基金备案  城市经济
城市经济  证券数据库
证券数据库  招股书
招股书  证券研究
证券研究  上市发行
上市发行  商业数据库
商业数据库  专业数据
专业数据 








